2023�껪�Ϲ����������졢�Ƚ����Ӽ����⼼�������ᣨ���LEAP Expo�����³�ԱչĽ��ڻ��ϵ��������豸չ����10��30-11��1�գ��ٴε�½���ڹ��ʻ�չ���ģ������¹ݣ���չ�ὫΧ���Զ������˶����ơ����Բ�����������װ���㽺ע��&�������ϡ������ӹ����뵼���װ�����졢�ǻ۹���������������ҵǰ�أ��۽��¾ɶ���ת����Ϊ��������������ҵ�ṩһ������ҵ�����ε�רҵ����Ȧ��

*ͼԴ��2022��չ�ᾫ��˲��
ʵ��Ԥ�Ǽǣ��ֳ����Ŷ�
�� ��ɨ���Ϸ���ά�룬����Ԥ�Ǽ�ҳ�� ��
оƬ��չ�����Ħ��ʱ�����Ƚ���װ�ѳ�Ϊ��������ϵͳ���ܵĹؼ����ڡ���5G�����������˹����ܺ����ܼ���ȸ����ɶȵ������£��Ƚ���װ�г�����Ԥ�Ƹ��ڴ�ͳ��װ��Ľ��ڻ��ϵ��������豸չ˳Ӧ��չ���ƣ��������뵼���װ����������չ������Χ��Mini LED��װ��SiPϵͳ����װ��IGBTģ���װ�ȼ�������Ϊ����������������ḻ�����崴�½��������
�뵼�����조��̲���Ƚ���װ���г�
�ڱ���Ľ��ڻ��ϵ��������豸չ�ֳ�������о����о���ܡ��пƹ��ɿƼ�����ư뵼�塢����Ƽ����⻪�Ƽ���һ����ҵ����չ���ֳ�����չʾ��Բ�����豸���Ƚ���װ�����ͷ�װ���ϣ�ʵ�ֵ�����ҵ��Ӧ����Դ���������ٵ��Ӳ�ҵ���뵼���ҵ���ںϡ�

�ڹ㷺�����ӹ�������оƬ�����ǹؼ��Ĺ���֮һ��ÿһ�Ű뵼��оƬ�ĵ�������Ҫ������ϸ����ƺͷ������Ƴ̡�ͨ�����ԣ��뵼�����칤�շ�Ϊǰ�����պͺ�����գ�Խ��Խ��ı����豸���̿�ʼ�ڸ����������Ϻ����������豸�ɷ�����˾(Shanghai Techsense Co., Ltd)��רע�ڴ��°뵼��ǰ����Բ���죬�����⡢���ܶ�HDI/IC�ذ����켰��������������ҵ��ʹ�õĸ߾��ܸ߿ɿ����豸���з�������ĸ��¼�����ҵ����Ҫ��Ʒ������Բ�����弶�Ƚ���װ�ͻ�����BGA���ֲ�����豸��IGBT��SICģ���װ�Ķ�оƬ��װ�����뵼��оƬ��ۼ���ѡ�����߾��ȹ�����Ƭ���������������Բ��ѡת�����豸������ת�����豸����������ĸ���ͻ����Ƹ���ϵͳ��Ӳ��+�������ȡ�
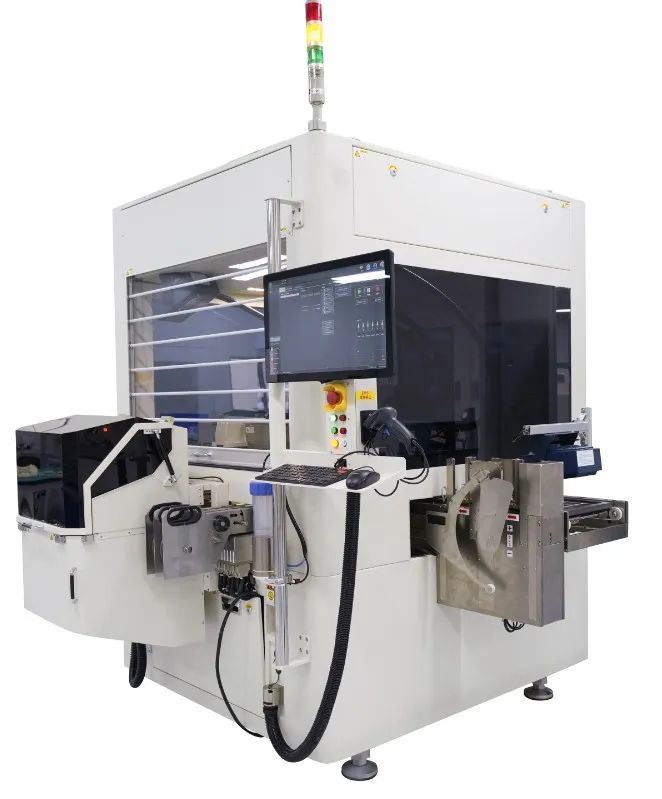
���ʰ뵼��ģ��DSC����
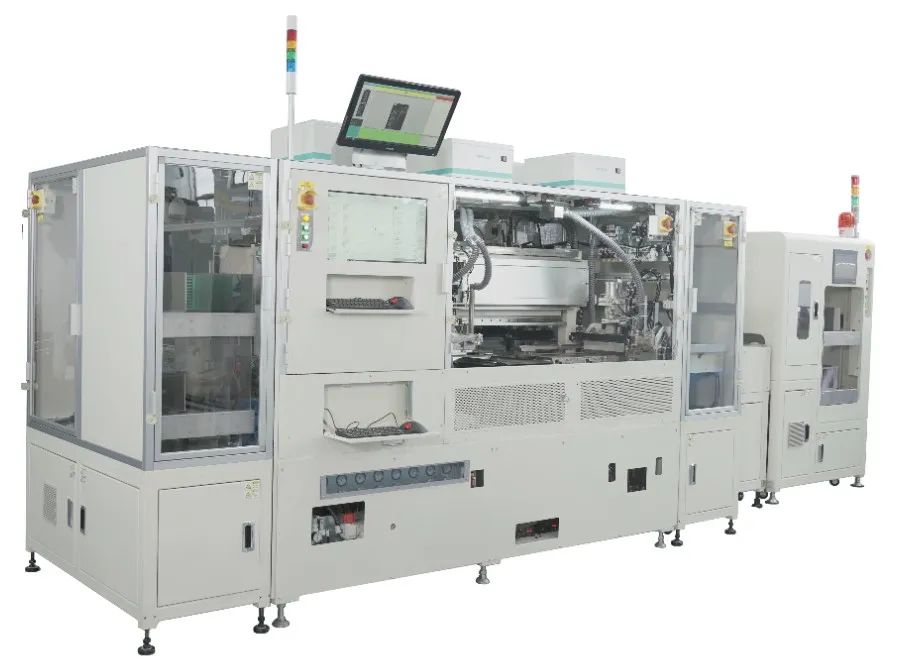
�人��о�Ƽ�����˾��һ��רע��оƬ(IC)��¼�����������豸�з������������۵ĿƼ���˾����������оƬ��¼�����û��ṩרҵ��оƬ��¼���Խ�������Ͳ�Ʒ��ϵ��ͨ����оƬ��¼��(�����)����ET9800(1��8)��ET6800(1��4)��ET2800(1��2)�ȣ�����ͨ������չ������Ӳ����Ƽܹ���ͬһ����¼��֧����Ƭ(SMT)ǰ����(��Ƭ)��¼����Ƭ(SMT)���ڰ�(ISP)��¼�����Ǽ�֧�ֵ���������¼����֧�ִ�Һ�����������ѻ���¼��ȫ��֧�ָ���оƬ(������MCU��EMMC��SPI Nor/NandFlash��Parallel Nor/NandFlash��EEPROM��FPGA��DSP��CPLD��)�İ�ȫ���ȶ�����Ч������¼��

�뵼������ע���豸Ҳ�ǰ뵼����������Ҫ���豸֮һ�������Խ�����ע�뵽�뵼������У��Ӷ��ı��䵼�����ܡ����������Ҫ����ջ����н��У��Ա������ʶ뵼����ϵ�Ӱ�졣��ʽ������댧����һ��λ���ձ��������ĵ�������װ�������̣����������������������պʹ���ѹ��������װ�á���������װ���ڰ뵼��͵���������칤�������ڱ�����ԣ�����������Ĥ������ۻ�Ĥ����������ϴ��Ϳ��Ȳ��ճ���Ե���ߡ��ر��ǣ�ͨ�������������ĵ����Ӵ�������Ӧ����������棬��������Һ�������˷ѣ����Һ�����ľ�ȷ�ȡ���ʪ��Ϳ�㲻ͬ�����ִ�����ʹ���ܼ�����˷dz�������ҽ����;��
����ֵ��ע����ǣ��ڰ뵼������ĺ�������У��봫ͳ��װ������ȣ��Ƚ���װ����С�ͻ����ᱡ�������ܶȡ����ĺ����ںϵ��ŵ㡣Yole������ʾ��ȫ���Ƚ���װ�г���ģ����2021��350����Ԫ������2026��482����Ԫ��2021-2026���CAGRԼ8%������2022��ȫ���Ƚ���װ�г��ﵽ378����Ԫ�����ͬ�������װ�г��ʹ�ͳ��װ�г���CAGR=2.3%�����Ƚ���װ�г���������Ϊ��������Ϊȫ�����г�������Ҫ������
Ŀǰ�����е�װоƬ��FC���ṹ�ķ�װ����Բ����װ��WLP�����ȳ��ͷ�װ��Fan-out����ϵͳ����װ��SiP����2.5D ��װ��3D ��װ�Ⱦ�����Ϊ�����Ƚ���װ���룬��Щ�Ƚ���װ����ʹ��RDL��Bumping��TSV �Ȼ������ռ�������ͬ����֮��Ҳ���ڷ�չ�εĵݽ���������оƬ/Chiplet��о������ƽ����ͨ���н�㡢���š����ܶ�RDL�ȷ�ʽ���ӵ�2.5D��װ��������Ѵ洢������оƬ�ڴ�ֱά�Ƚ��жѵ���3D��װ����ChipletΪ������Ϊһ�ֿ�ƽ�����������ɱ������������ȣ�������IPģ�龭���Ժ����Ե��¼���֮һ��Chipletʵ��ԭ����ͬ���ľһ������һЩԤ���ڹ������������õ�ʵ���ض����ܵ�оƬ��Ƭ��ͨ���Ƚ��ļ��ɼ�������3D���ɵȣ���װ��һ�𣬴Ӷ��γ�һ��Ƭ��ϵͳоƬ��
�Ƚ���װ�����뵼���豸����������������������Ҫ�ʹ�ͳ��װ���Ƶķ�װ�Ͳ��Ի��ڣ�������Ϊ��������豸���̳ɳ����¶��������ݲ��ڰ뵼������˾�۽��뵼���װ���Եȹؼ��Σ��ڹ������̾���AOl ��⡢��ϴ�Ĵ������̵�����װ���Ͻ��в��֣������ͻ���оƬ��װ�����ȹ��ջ��ڵ����������ʵ���ȶ�������������ϵ�й������Ǹ߾��ȸ�Ч�ʵĶ��оƬ��װ�豸��������ƬЧ�ʿɴ� 15~35s/pcs����Ƭ���ȡ�0.5~��3um���߱�������Ƭ��պ����Ƭ�� Flip Chip ��Ƭ���ܣ��������оƬ��װ����ģ�黯���������ʹ��߱������������������䱸����У�����ݹ���ϵͳ��ʹ��߱��������������������
*ͼԴ�����ݲ���
Mini LEDӭ������
�����豸��ҵ���߽��ع�����ʱ
����չ�����������а뵼���ҵ��չ�ٽ���Я��ɭ��˼̩�ˡ�����������ء����ء���ï��ʢ������ ���������ڶ��豸�̹�ͬ����Mini LED��װ�����ߡ�

Mini LED�ֳơ��Ǻ���������ܡ�������100~200���� LED���壬�Ǵ�ͳLED����ĸĽ��汾��ʹ��Mini LED�ܹ�����0.5-1.2�������ؿ�������ʾ������ʾЧ��������ڴ�ͳLED��Ļ����ҪӦ������ʾ����������ʾ�����ֻ��Ϳɴ����豸������2018���п�ʼ��Pad�����ء��羺�����ӵ�Ӧ�ö˷��涼�����˶�Mini LED��Ũ����Ȥ��������ΪOLED����������г�������ƶ��£�Mini LED�������з����ڼ��ٽ��С��߹�����LED�о�����GGII��Ԥ�⣬��2025�꣬Mini LED�г���ģ���ﵽ53����Ԫ���긴�������ʳ���85%��MiniLED��ҵ���������Σ�����Ƭ+оƬ�����������죨��װ+ģ�飩�Լ������ն�Ӧ�������֡����У���װ���ڵ������оƬ������Ρ��ڷ�װ�����ϣ�POB��Package on Board����ҵ���׳Ƶ������Ƿ��������Ƚ�LEDоƬ��װ�ɵ��ŵ�SMD LED���飬�ٰѵ�����ڻ����ϣ���Ŀǰ���ù㷺�ķ�װ��������Mini LED��ʾ����Ʒ����Ϊ�ձ飬�ŵ��dz���ȸߣ��ܹ������Ӧ����ҵ�ķ�װҪ���ҷ�װ�����빤��Ҫ��Ҳ�ϵͣ���ȱ���DZ���ģ���Ƚϸߣ����������ᱡ����COB��Chip on Board����װ������һ����֧���ͼ��ɷ�װ��������LEDоƬֱ����װ��PCB���ϣ���PCB���һ������֧�����ŵ�COB���ɶ�������弶��װ����PCB�����һ�沼������IC������������Ҫ�κ�֧�ܺͺ��ţ�����ģ�����������ᱡ����˵Ŀǰ�����������������ռ䣬��COB����ͻ���˷���оƬ��װΪ���顢������װ��PCB��������ߴ����ƣ�������ȶ��ԡ�������ʾ�����ص㣬��ΪĿǰ�г������˵���ʾ���������⣬����LED��ҵ�ķ�չ������ʾ��Ч��Ҫ��Խ��Խ�ߣ������Ҫ�Ե���LED��Ԫ����ĽǶ��������Ҫ���ҶԷֱ��ʵ�Ҫ��ҲԽ��Խ�ߣ������Ҫ��С����LED���⾧Ԫ�ijߴ��С����Mini LED��ҵ�������Ժ�Ҫ���ڼ����и����Ҳ���һ���о����µ��и����ʹ���ܹ������µ�����Ҫ���㶫���ؼ���Ƽ�����˾����ĸ��˾�������ؼ���Ƽ�����˾������2014�꣬��һ��רע�ڰ뵼�塢����Դ�����⾫���ӹ��������������������ĸ��¼�����ҵ��������ɽ����ݸ�����������з������졢���ۻ��ء��������з�����߶˾��ܰ뵼�弤��ӹ��豸���������Ӽ���ӹ��豸���Ӿ�����豸�ȡ���˾�Ӽ�������װ�������Զ������ߡ������ӹ�ϸ������ȣ����Ϸḻ��Ʒ�ͽ����������3C���ѵ��ӡ�PCB/FPC�������ʾ���뵼�塢����ʯ��5GͨѶ������Դ�������մɵȶ���������չ������+�������족����ռ䡣
ȫ�Զ�AOI����

miniLED�����ڽ���

ȫ�Զ�miniLED�����и��
*ͼԴ�����ؼ���
Mini LED����ҵ����������ҵ������������س��̶��ڻ��������������ȴ�Mini LED�ı�������Ҫ�����г��Ŀ�����������װ��Ӧ�ö˵Ĺ�ģ�����豸�������Ҫ��ͬ������Mini LED��ҵһ�����ڿ����������ʵ�ֲ�����������һ����ѡ����õ��豸����������Ʒ���ʲ����ͳɱ�����ҵ�ڳɱ��Ż��У���Ӧ���ɱ�Խ�ͣ�����Ż�Խ�ߡ�������Mini LED����������������Ϊ�ھ���оƬ����װ�Ȼ��ڣ������豸ƾ�����Ч�ʺ��Լ۱ȵȸ������ƣ��Ѿ���Ϊ��װ����ʾ���̵��³衣
Ԫ������װ���֮
IGBT��װ������Ӧ����̳
������2023��10��30��-11��1�������ڹ��ʻ�չ���ģ������¹ݣ��ٰ��2023��Ľ��ڻ��ϵ��������豸չ�ϣ��뵼���װ����������չ������������Ԫ������װ���֮IGBT��װ������Ӧ����̳��������⽫Χ��IGBT�г���չ�������ơ�IGBT��Բ���칤�ա�IGBT�սᡢ���ϡ��豸Ӧ�ð��С�ʧЧ�����Ȼ���չ�����̽�֣������������ӡ�����Դ���������Դ��������ҵ�Ĺ��չ���ʦ������ʦ��������Ա���о�Ա��ר�ҵ�ͬ�������̽��IGBT ��װ�����ķ�չ���ƺ�Ӧ��ǰ����
�ݽ���ҵ����
�� �г��ൺ�����о���
�� ���ݹ��̻�е����
�� �¹�Zestron
�� ���������Ƽ�����˾
�� ��ݸ���ܵ¿Ƽ�����˾
�� ʤ�����ף����ݣ��ɷ�����˾
......

ɨ���ά������������ϯ